BGA封裝是芯片底部處引腳由錫球所取代的方式,幾百顆微小錫球固定其通過助焊劑定位後以表面貼焊技術固定到PCB,底部錫球的排列恰好也要對應到基闆相應位置。 随着芯片升級與性能的不同封裝要求,對基闆與焊點的清潔度要求也越加提高。
旋風清潔目前應用在以下芯片封裝領域,并可根據用戶客戶需求擴大應用 :
CPU Board制造時的清潔工程
DRAM器件芯片的BOC封裝清潔
-FCBGA倒裝芯片球栅格陣列、圖形加速芯片實裝前的清潔
FBGA Board基闆、印刷、鍍層、背膠、AOI檢測等制造環節的清潔
1. FBGA Board AVI & AOI前 上部、底部清潔
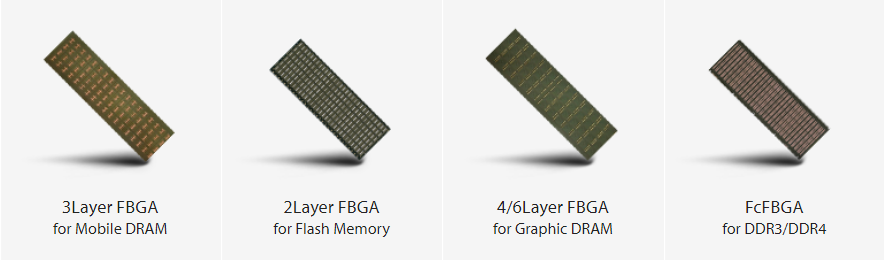

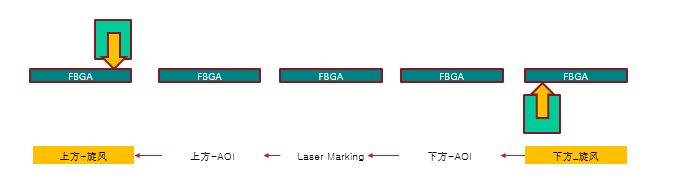
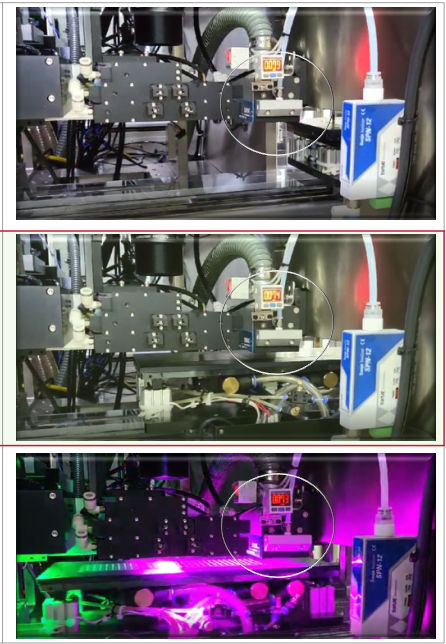
2. Silk&PSR印刷前印刷前附着異物清潔
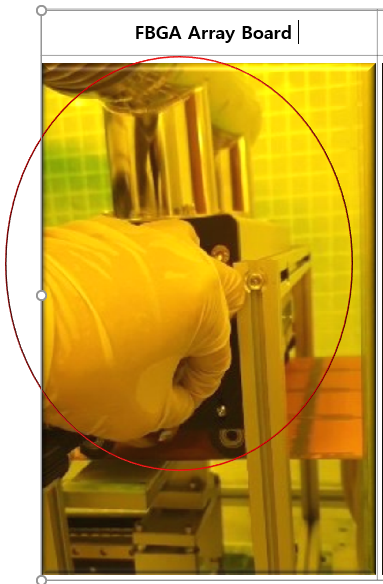

3. Cu Foil Lamination貼合前附着異物清潔
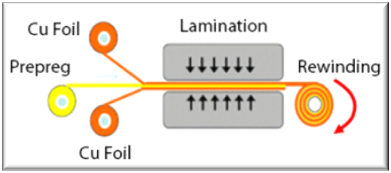
4. Exposure D/F Laminating 貼合前附着異物清潔
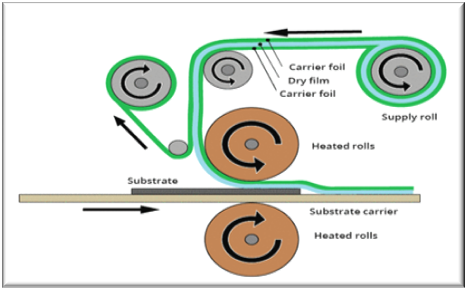
5.Dump工程 PAD & Via Hole附着異物清潔;實裝基闆部位,衆多VIA Hole裏附着異物的清除
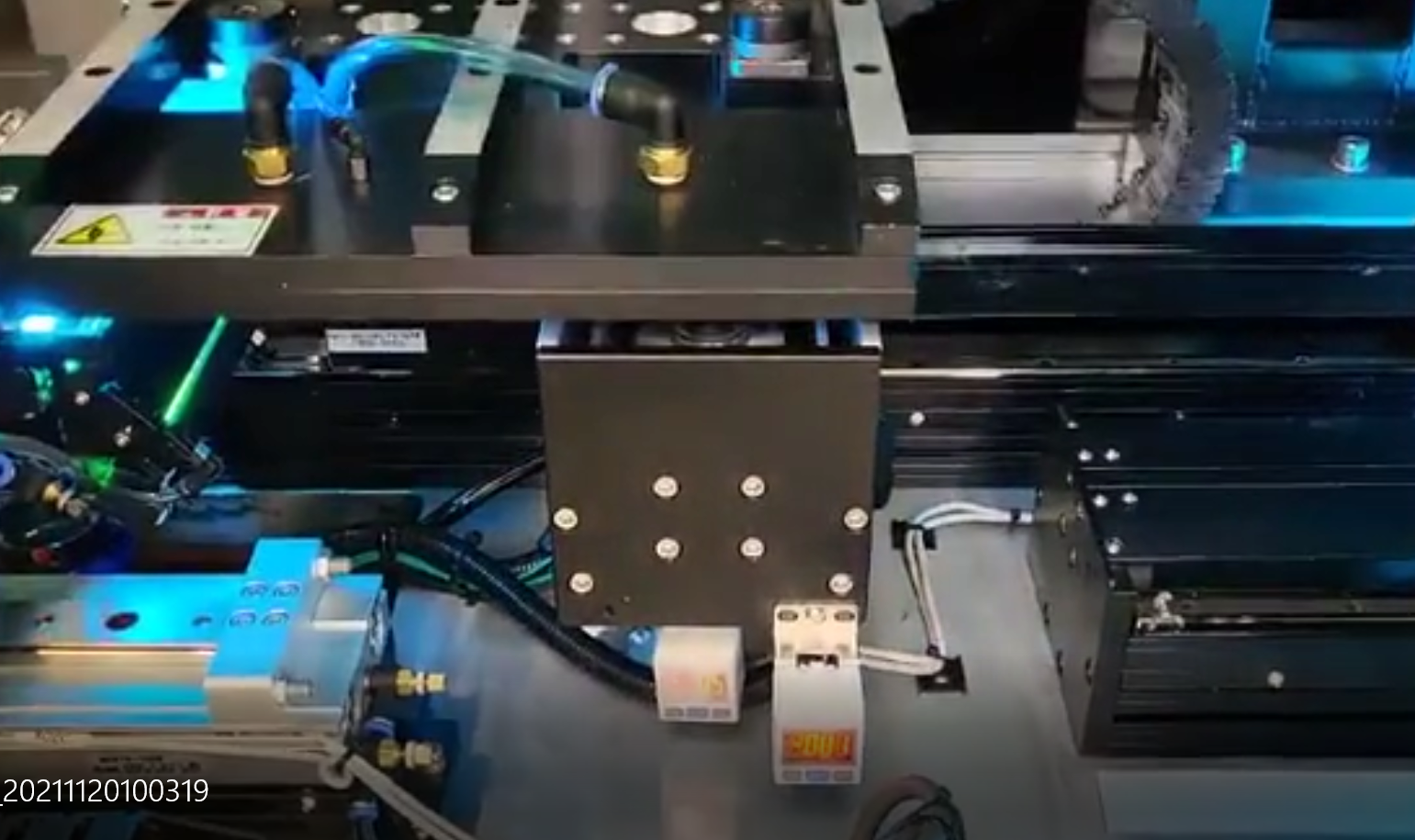
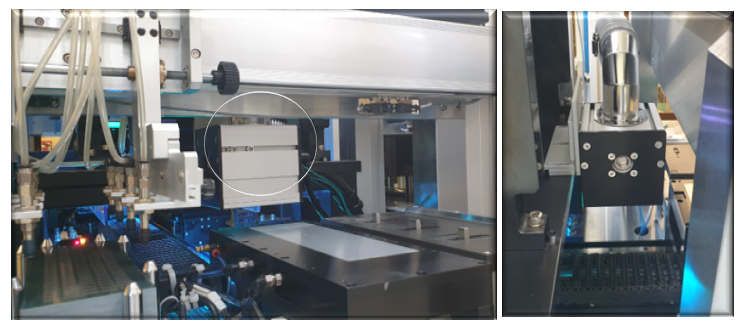
6.Back Side Tape Laminating 貼合前附着異物清潔
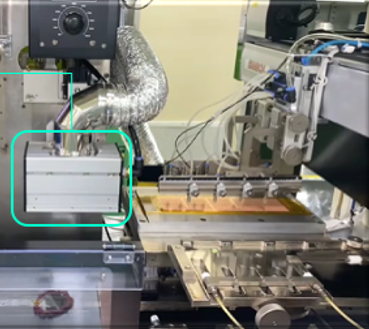

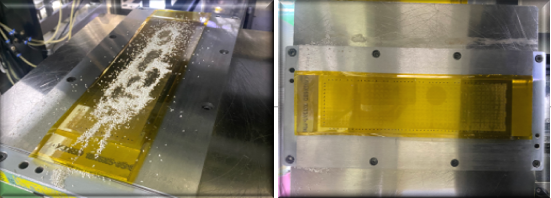
7. CPU 制造過程托盤清潔